一、SiP 封裝概述
系統級封裝 SiP(Single In-line Package),是一種單列直插式集成電路封裝技術。其引腳設計為從封裝單側引出且呈直線排列,當裝配至印刷電路板時,SiP 封裝呈現側立狀態。該封裝技術規定引腳中心距為 2.54mm,引腳數量通常在 2 至 23 個之間,且多為定制化產品。
從功能實現角度,SiP 封裝是將多個具有不同功能的有源電子元件與可選無源器件,以及諸如 MEMS 或者光學器件等其他器件進行優先組裝,形成一個具有一定功能的單個標準封裝件,從而構成一個完整的系統或者子系統。
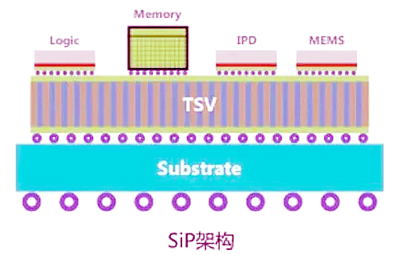
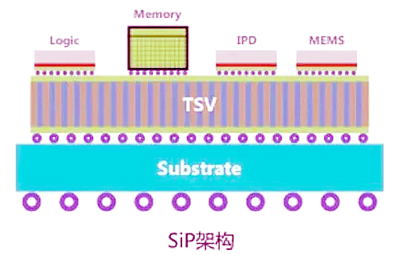
二、SiP 封裝類型
依據目前業界的設計類型及結構,SiP 封裝可分為三類:2D SiP、堆疊 SiP 和 3D SiP。
2D SiP 封裝 :在同一個封裝基板上,將芯片以二維模式一個挨一個排列,最終封裝在一個封裝體內。
堆疊 SiP 封裝 :在一個封裝中,采用物理方法將兩個或多個芯片進行堆疊整合,然后進行封裝。
3D SiP 封裝 :在 2D 封裝的基礎上,將多個芯片、封裝芯片、多芯片甚至圓片進行疊層互聯,形成三維立體封裝結構,也稱作疊層型 3D 封裝。
三、SiP 封裝工藝
SiP 封裝的核心工藝涵蓋晶圓減薄、芯片貼裝、互連形成和封裝體構建等關鍵步驟。
(一)晶圓準備與減薄
原始晶圓厚度約為 700pm,需研磨至 200pm 以下,對于疊層存儲芯片更是需要減薄至 50pm。該流程具體包括貼膜保護、背面研磨以及清洗環節,每一步都需謹慎操作,以防止芯片受損。
(二)芯片貼裝(Die Attach)
采用銀膠(環氧樹脂與銀粉的混合物)將芯片粘接于基板之上,同時要對溫度(120°C)和壓力進行精準控制,以確保芯片與基板粘接的牢固性。此過程的關鍵設備包括固晶機、Pick up head 等。
(三)互連技術
引線鍵合 (Wire Bonding) :采用傳統金 / 銅線連接方式實現芯片與基板的互連。
倒裝焊 (Flip Chip) :借助凸點直接連接芯片與基板,能夠實現更高的連接密度。
(四)封裝體構建
包括錫膏印刷、回流焊、清洗以及最終的包封保護等一系列操作。
根據芯片與基板的連接方式,SiP 封裝制程主要分為引線鍵合封裝和倒裝焊封裝兩種類型。
四、引線鍵合封裝工藝流程
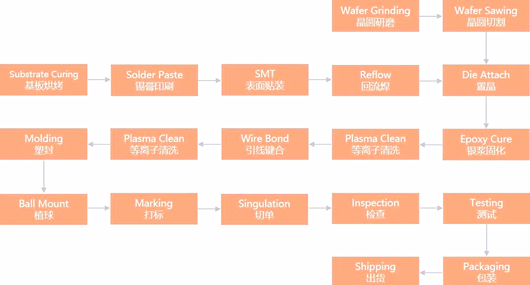
五、SiP 封裝的應用領域
SiP 封裝技術以其高度集成、節省空間的優勢,在多個領域展現出廣泛的應用前景。在消費電子領域,隨著電子設備不斷向小型化、多功能化發展,SiP 封裝能夠將多種功能模塊集成在一起,滿足如智能手機、平板電腦等設備對于高性能、小尺寸的要求。例如,可將處理器、存儲器、射頻模塊等功能芯片進行 SiP 封裝,從而實現設備的高速數據處理、大容量存儲以及穩定的通信功能。
在物聯網領域,傳感器網絡節點通常需要具備多種功能,如環境感知、數據處理和無線通信等,而 SiP 封裝可以將微處理器、傳感器、通信芯片等集成在一個小型封裝內,為物聯網設備的快速部署和高效運行提供有力支持。
在汽車電子方面,SiP 封裝可用于車載信息系統、高級駕駛輔助系統等,將多種芯片集成封裝,能夠提高系統的可靠性和穩定性,同時也有助于減小汽車電子模塊的體積,為汽車的智能化、電動化發展提供技術支撐。
〈烜芯微/XXW〉專業制造二極管,三極管,MOS管,橋堆等,20年,工廠直銷省20%,上萬家電路電器生產企業選用,專業的工程師幫您穩定好每一批產品,如果您有遇到什么需要幫助解決的,可以直接聯系下方的聯系號碼或加QQ/微信,由我們的銷售經理給您精準的報價以及產品介紹
聯系號碼:18923864027(同微信)
QQ:709211280


